-
반도체 공정 #4 PhotolithographyⅡ EUV & Process issue +αSemi-process 2022. 2. 2. 16:55
EUV(Extreme Ultra Violet)
다층 유리를 통한 파장에서 광 및 마스크의 반사를 활용하는 기술로, 극 자외선 파장을 이용
다층 코딩한 거울을 통해 상을 축소시키는 역할
거울은 총 4개로 구성 되며, (Paraboloid1, Ellipsoid2, Plane mirror1 으로 구성되어진다)
Chamber안은 진공 상태를 유지시켜 줘야한다. (모든 물질에 흡수가 잘되기 때문에)
EUV 사용의 장점
1. λ 감소 → 해상도 극대화 (7nm) 기존의 (Arf + immersion + QPT 는 10nm의 λ 값을 가짐)
2. 작은 횟수의 패터닝으로 구현이 가능하다 → 공정수 대폭감소
EUV 사용의 단점
1. Arf 장비의 2배 가격
2. 흡수를 막기 위해 장비내 진공 상태를 만들어야 한다.
3. 생산성이 부족하다.
4. 반사효율이 높다 (70%)
*pellicle: 노광시 mask-pellicle-wafer 순으로 놓는데 EUV공정에서 Pellicle이 문제가
될 수 있다. 즉 EUV의 Pellicle은 13.5nm light가 투과 되고 기계적인 강도가 커야한다. 이는
현재로써는 불가능하다. 따라서 특정 %를 투과하면서 높은 강도를 가진다던가 하는 방식으로 높은 투과도와
수율 사이에서 최적의 접점을 찾아야한다.

기존 litho 와 EUV 비교 Photolithography Process issue and solution

1.PSM(phase shift mask)
빛이 퍼져서 서로 중첩이 되면 보강 간섭이 일어나 해상도가 감소
Sol: 상이 정확하게 180도 반대가 되는 Mask를 하나 더 써서 빛의 phase를 180도 바꾸는 방법을 사용한다.
즉 빛이 서로 상쇄간섭을 일으켜 해상도가 좋아진다. ( 작은 패턴 형성 가능해짐.)
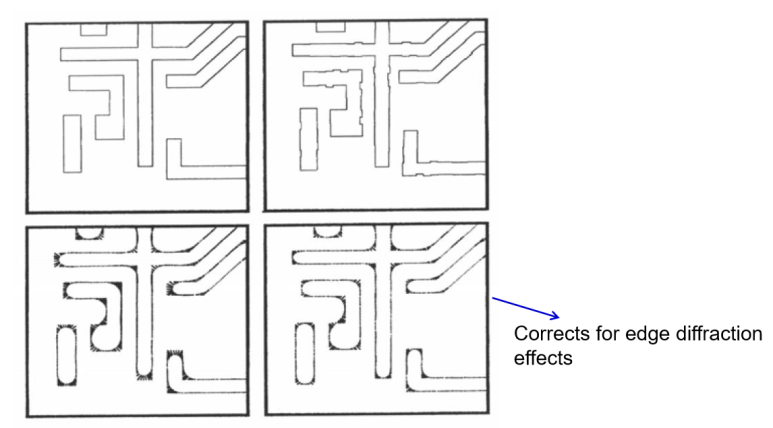
2.OPC(Optical proximity correction)
Proximity effect란 에너지를 가하려고 하지 않은 곳에
회절 등의 이유로 에너지가 가해지는 현상이다. 이는 회절 현상이 Coner에서 가장 많이 일어나기 때문에
Conor부근에 Proximity effect가 가장 크다.
Sol: 회절이 가장 많이 일어나는 부근에 Notch같은 것을 만들어 패턴 왜곡을 감소시킴

3.Topography Reflection effect on Resolution
표면에 Roughness가 존재할 때 반사가 잘되는
금속 등에 2차 노광이 발생할 수 있다. 그렇게 되면 원하지 않는 노광 때문에 패턴 왜곡이 일어난다.
Sol: 튀어나온 거친 부분을 없애기 위해 CMP를 진행하거나 PR도포 전에 Metal에
anti-reflection coating을 사용해 반사가 안되도록 조치를 취한다.
+α
1. DPT(Double Patterning Etch)

1-1. LELE 법
Double photo + Double etch 라고도 불리는 LELE법은 2개의 Reticle을 겹치지 않게 쌓은후 PR을 진행하는 공정이다.

1-2. SADP 법(Self- Aligned DP) 2. Immersion Lithography
Resolution 측정 렌즈의 크기를 N.A는 n x sina로 표현한다.
이때 n을 증가시키면 Resolution 값이 증가한다. 따라서 wafer와 mask사이에 물을 집어 넣으면
wafer-water-mask 구조가 되는데 기존 air일때는 n = 1이지만 사이에 water 가 들어가면
n값이 1.44로 증가해서 Resolution 이 좋아진다.
3. Dual tone PR develop
빛의 특정 Intensity 이상 & 이하를 제거하는 방법.
특정 범위 안에 들어온 빛만 남게 되어 패턴 사이즈 미세화 가능
'Semi-process' 카테고리의 다른 글
반도체 공정 #6 Deposition - PVD (0) 2022.02.13 반도체 공정 #5 Ethching (0) 2022.02.07 반도체 공정 #3 - Photolithography (0) 2022.02.01 반도체 공정 #2 - Oxidation (0) 2022.01.30 반도체 공정 #1- Preview & Clean room (0) 2022.01.29